PCBA檢測儀器使用方法及判斷規格介紹
日(ri)期:2019-05-27 / 人氣: / 來源(yuan):www.scqhky.com
300X顯微鏡
使用步驟
1.將(jiang)要(yao)觀察之物品放置于平臺上(shang).
2.調整適當倍率及焦(jiao)距至(zhi)最清晰(xi)畫面.
3.使用360°旋(xuan)轉鏡頭觀察該物(wu)品之狀態.
應用范圍
1.零件(jian)吃錫(xi)面(mian)高(gao)度判定.
2.空,冷焊(han)判(pan)定.
3.異(yi)物辨識與錫(xi)珠(zhu)辨識.
4.零件破裂情況觀(guan)察.
5.其他.
判斷案例
 異物介入 |
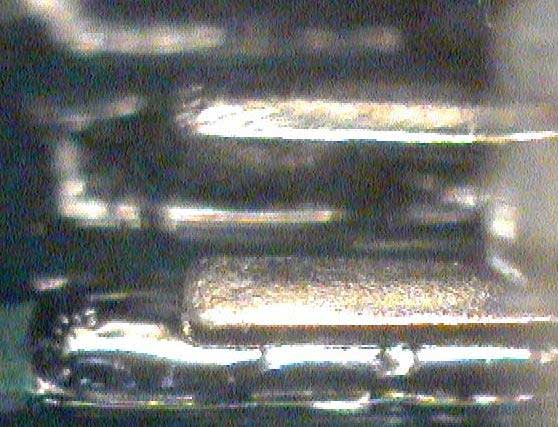 零件腳不吃錫 |
 吃錫不良 |
 良品 |
判定規格
1.吃錫(xi)面高度需(xu)高于(yu)25%.
2.錫珠大(da)小需小于18um,同一板上不得(de)大(da)于7顆.
3.零件不可有破損.
4.不(bu)可有爐(lu)膛(tang)助焊劑(ji)滴落板上(shang)與(yu)棉絮殘(can)留等異物.
5.其(qi)他(ta)依外觀檢驗(yan)標準.
備注:1.可依需求選(xuan)擇使用平面鏡(jing)或(huo)側視鏡(jing).
紅墨水試驗
使用步驟
1.先使(shi)用(yong)336A清(qing)潔(jie)機(ji)板(BGA間距(ju)內(nei))上之助焊劑殘留物(wu).
2.將待(dai)測物灌(guan)入(BGA gap)適量(liang)紅墨水.
3.確認紅墨(mo)水已完(wan)全滲入(ru)間隙中后再將待(dai)測(ce)物(wu)放入(ru)烤箱(xiang)烘烤(以120℃約60min).
4.以鉗子將BGA強(qiang)制拆(chai)除(chu).
5.使用300X顯微(wei)鏡觀(guan)察(cha)PCB&BGA的相對應pad是否有(you)紅墨水(shui)滲入,若有(you)即表示該接合(he)點(dian)有(you)crack或空焊.
應用范圍
1.零件(BGA)接(jie)合面crack.
2.零(ling)件(BGA)接(jie)合面空焊.
判斷案例
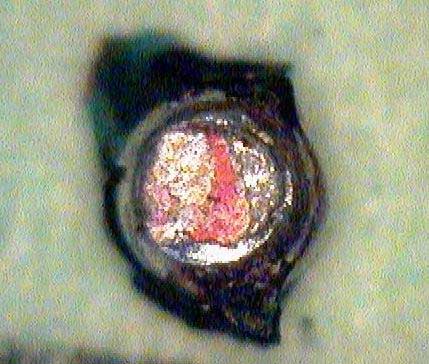 Crack |
 焊接不結實 |
判定規格
若(ruo)有(you)紅墨(mo)水滲入PCB&BGA的相對應(ying)pad即表(biao)示(shi)該接(jie)合點(dian)有(you)crack或空焊現象.
備注
此工具(ju)運(yun)用于Fiber Inspection,X-Ray無法觀察(cha)到異常,而(er)又(you)無法確(que)認異常點是在(zai)那一個(ge)pad時.
切片
使用步驟
1.將壓克力粉與硬化(hua)劑以1:1比(bi)率(lv)適量攪拌.
2.將待測物以壓(ya)克力夾夾住并(bing)放置在盒內.
3.將攪(jiao)拌均勻(yun)之壓(ya)克力劑適(shi)量(liang)倒入盒內,約等30min待(dai)其(qi)固化(hua)再取(qu)出.
4.再將待(dai)測(ce)物由研磨(mo)(mo)機磨(mo)(mo)至不良點(經由粗磨(mo)(mo)-->細磨(mo)(mo)-->拋(pao)光).
應用范圍
1.Crack(BGA接合面,零(ling)件(jian)腳,零(ling)件(jian)內部).
2.空焊(BGA內部錫(xi)球接合面).
3.Cold Solder(BGA內部(bu)錫球接(jie)合面(mian)).
4.各零件腳接合面(mian)觀(guan)察.
判斷案例
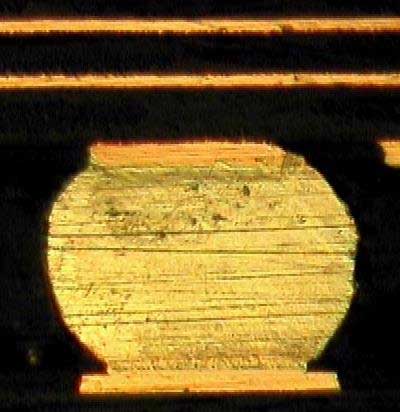 良品 |
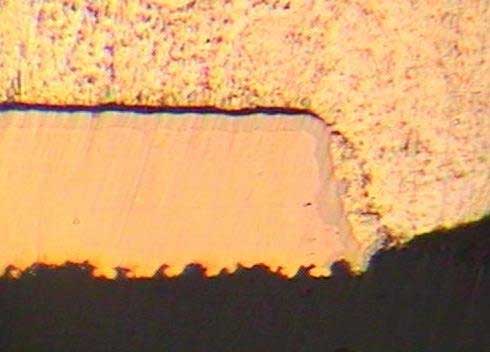 Crack |
判定規格
1.此工具(ju)是(shi)在(zai)確定不(bu)良點(dian)時(shi),再研磨至(zhi)該不(bu)良點(dian),用(yong)以確認(ren)其實際不(bu)良原因,輔助對策之下(xia)達.
備注
常(chang)配合SEM&EDS使用.
SEM&EDS
使用步驟
目前(qian)廠內無此儀器,若有需求時以(yi)送外分析方式進行.
1.先以SEM取(qu)得適(shi)當(dang)之倍率,確定不(bu)(bu)良(liang)物(wu)位置(zhi)(可(ke)量測不(bu)(bu)良(liang)點大小).
2.以(yi)光(guang)標點(dian)選測試不良點(dian)位置進行表(biao)面EDS量測.
應用范圍
1.SEM:觀測被測物表面上之細微(wei)異常現象(xiang).
2.EDS:測試被(bei)測物體表面元素與含量分析(例如用(yong)于零件pad或PCBpad不吃錫使用(yong)).
判斷案例
 SEM |
 eds |
判定規格
1.取良品與(yu)不良品同時做(zuo)此較測試,觀察其(qi)測試結果之元素含量是否有異(yi).
2.確認所測得之元素比率(lv)是否(fou)有超出標準或(huo)含有異(yi)常(chang)成分,若有即表示異(yi)常(chang).
側邊顯微鏡
使用步驟
1.調整鏡頭高度至(zhi)PCB&BGA substrate間(jian)距之(zhi)間(jian).
2.調整光源與焦聚使畫面達到最清晰為止.
3.移動(dong)鏡(jing)頭時需將鏡(jing)頭上升再移動(dong),以防止鏡(jing)頭損壞.
4.觀察BGA四周是否有(you)crack時,須配合使用尖銳物輕微(wei)將BGA substrate翹起才可看到Crack.
應用范圍
1.solder joint(錫球焊接面好壞判斷).
2.空,冷焊及短路判斷(duan).
3.Crack判斷(duan).
4.異物介入(判斷是否有異物或助焊(han)劑過多).
判斷案例
 Crack |
 良品 |
判定規格
1.錫球(qiu)與(yu)PCB錫膏有接觸但未接合(he),且表(biao)面不平(cold solder).
2.接(jie)合面間(jian)有污(wu)染物.
3.solder ball與PCB(orBGA)pad撥離(crack).
備注
1.Fiber Inspection只能看到外圈(quan)錫球(qiu)的接合(he)狀況,若(ruo)為內部接合(he)問(wen)題需(xu)使用(yong)其他(ta)工具.
X-Ray
使用步驟
1.將待測物放入機臺平臺(若有(you)需要旋(xuan)轉時需固定).
2.調整power & X-Ray head高度.
3.選擇Solder Ball中(zhong)最大Void并(bing)量測其面積.
應用范圍
1.檢(jian)視BGA短路.
2.檢視Solder Ball的Void.
3.若為(wei)明顯空焊時亦可以看出.
4.BGA缺球.
判斷案例
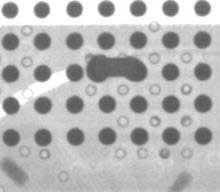 短路 |
 孔洞 |
判定規格
Void Spec.(IPC7095):
1.class 1:
in solder ball center:D<60%;A<36%
inpad(PCB&BGA):D<50%;A<25%
2.class 2:
in solder ball center:D<45%;A<20.25%
in pad(PCB&BGA):D<35%;A<12.25%
3.class3:
in solder ball center:D<30%;A<9%
in pad(PCB&BGA):D<20%;A<4%
使用步驟
1.將待測(ce)物(wu)放入機臺(tai)(tai)平臺(tai)(tai).
2.以游標(biao)點選(xuan)基(ji)準(zhun)點與待測區.
3.按”Run”key自動量測錫膏印刷質量.
應用范圍
1.錫膏厚度,面積,體(ti)積量測.
2.3D模擬(可用(yong)以判定印刷質量,如錫尖).
3.SPC統計.
判斷案例
 |
 |
錫膏印刷檢查機(ASC)
判定規格
依目前廠內錫(xi)膏厚(hou)度量(liang)測標準(0.175~0.191mm)
480倍鋼板檢查機
使用步驟
1.將待測(ce)物放入(ru)機臺平臺.
2.將(jiang)倍率調(diao)整到40*1或40*2倍率.
3.調整屏幕(mu)畫面至(zhi)最清晰時,進行畫面擷取與量(liang)測(ce)開孔尺寸,并觀察其孔壁(bi)狀況(kuang).
應用范圍
1.鋼板開(kai)孔(kong)與缺角之尺寸量(liang)測(ce).
2.鋼板孔(kong)壁毛邊檢視(360°&34度(du)角檢視功能).
判斷案例
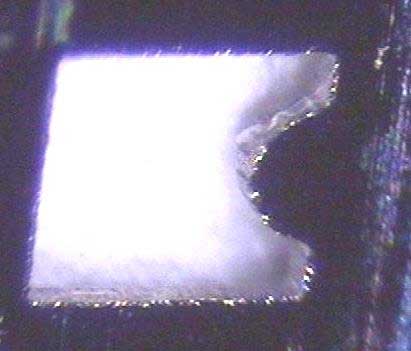 開孔不良 |
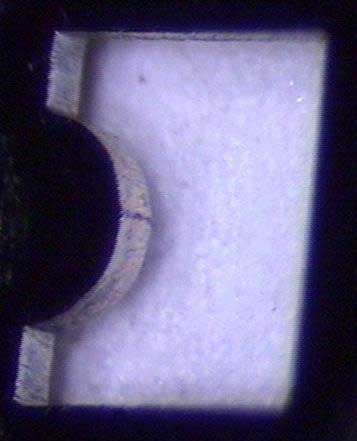 良品 |
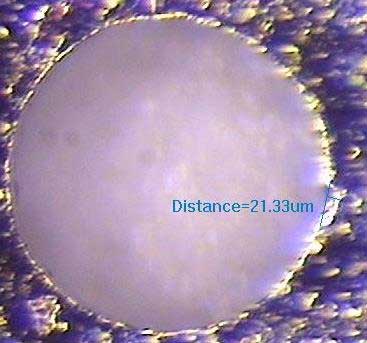 開孔不良 |
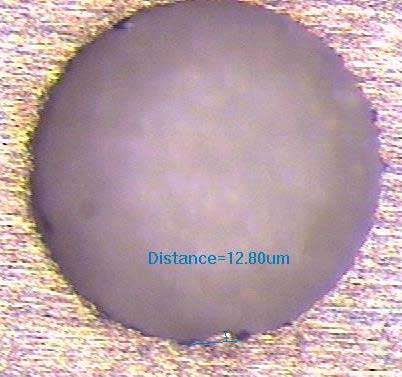 良品 |
判定規格
1.鋼板開孔(kong)之尺寸:
uBGA與IC類零件(如TSOP,QFP...):<±7um
其他零(ling)件開孔:<±10um
2.缺角:<11um
3.其(qi)他規(gui)格請依Stencil Design Rule
使用步驟
1.取回功(gong)能性測(ce)試(shi)(F/T)正常之主板.
2.進(jin)行熱機,經(jing)過六天熱機測試后,若為正(zheng)常再將主板裝箱(xiang)進(jin)行振(zhen)動實驗2小(xiao)時(x,y及(ji)z各2小(xiao)時).
3.當(dang)進(jin)行完振動實驗后(hou),將主板(ban)取出再做(zuo)功能(neng)性(xing)測試及熱機(ji)8小時(shi)以確保主板(ban)是(shi)否功能(neng)正常.
4.若(ruo)功能(neng)測試為正常就(jiu)送回在線,反之則立即針對此機(ji)種大(da)量(liang)進行振動測試以尋(xun)求解決方式.
應用范圍
1.產(chan)品可(ke)靠度抽檢.
2.新制(zhi)程,新錫膏與新材料測(ce)試.
判定規格
測(ce)試(shi)零(ling)件(jian)與基(ji)(ji)板(ban)忍受10至55Hz振(zhen)動之(zhi)能力.倘若在振(zhen)動試(shi)驗后,發現(xian)破(po)裂現(xian)象(xiang)或(huo)其它足以(yi)影響正(zheng)常功能之(zhi)要求(qiu)時(shi),該零(ling)件(jian)或(huo)基(ji)(ji)板(ban)即不合(he)格.
ORT
使用步驟
1.在生產(chan)線(xian)測試完后,每條(tiao)線(xian)以(yi)逐(zhu)次(ci)抽樣5PCS(M/B).
2.試(shi)驗環(huan)境(jing)溫度(du)為(wei)(wei)攝氏45℃,30%RH,加(jia)速因子為(wei)(wei)3.4倍速.
3.約6天(144小時(shi))驗證(zheng)時(shi)間,將檢查結果(guo)記錄于(yu)ORTchart中(每日登記一(yi)次),并判別其(qi)坐標座落于(yu)何區域.
4.當(dang)其坐標(biao)位(wei)于繼(ji)續試驗區時,則(ze)繼(ji)續進行此試驗.
5.當其坐標位于(yu)允收區時(shi),即達到水平,并停止此試驗.
6.當其坐(zuo)標位于拒收區時(shi),分析不良之原(yuan)因.
應用范圍
1.產品(pin)可(ke)靠(kao)度抽檢(jian).
2.新制程,新錫膏與新材料測試(shi).
判斷案例

【格亞信電子】是專業從事電子產品設計、電子方案開發、電子產品PCBA加工的深圳(zhen)電(dian)子(zi)方案(an)公(gong)司,主要設計電(dian)子(zi)產品包括工控(kong)、汽(qi)車、電(dian)源(yuan)、通信、安防、醫(yi)療電(dian)子(zi)產品開發。
公司(si)核心(xin)業務是提(ti)供(gong)以(yi)工(gong)控電子(zi)(zi)、汽車電子(zi)(zi)、醫療電子(zi)(zi)、安防電子(zi)(zi)、消費電子(zi)(zi)、通訊電子(zi)(zi)、電源電子(zi)(zi)等多領域(yu)的電子(zi)(zi)產品(pin)設計、方(fang)案開發及加工(gong)生產的一(yi)站式PCBA服務,為滿足不同客(ke)戶需求可提(ti)供(gong)中(zhong)小批(pi)量PCBA加工(gong)。
公(gong)司產品(pin)涵蓋(gai)工(gong)(gong)業生產設(she)備(bei)控(kong)(kong)制設(she)備(bei)電(dian)(dian)子開(kai)(kai)發(fa)、汽車(che)MCU電(dian)(dian)子控(kong)(kong)制系統(tong)方案(an)(an)設(she)計、伺服(fu)控(kong)(kong)制板(ban)PCBA加(jia)(jia)(jia)工(gong)(gong)、數控(kong)(kong)機床(chuang)主板(ban)PCBA加(jia)(jia)(jia)工(gong)(gong),智(zhi)能家居電(dian)(dian)子研發(fa)、3D打印機控(kong)(kong)制板(ban)PCBA加(jia)(jia)(jia)工(gong)(gong)等領域(yu)。業務流程包(bao)括電(dian)(dian)子方案(an)(an)開(kai)(kai)發(fa)設(she)計、PCB生產、元器件采購、SMT貼片加(jia)(jia)(jia)工(gong)(gong)、樣機制作(zuo)調試、PCBA中(zhong)小批量加(jia)(jia)(jia)工(gong)(gong)生產、后期質保維(wei)護一站式PCBA加(jia)(jia)(jia)工(gong)(gong)服(fu)務。
http://www.scqhky.com/
作者:PCBA加工
相關方案
- 櫻花草視頻:車載導航儀電路板PCBA加工04-01
- 櫻花草視頻:變頻電源控制系統PCBA加工04-05
- 櫻花草視頻:電弧焊機主板PCBA加工04-13
- 櫻花草視頻:智能感應道閘控制板開發方案10-18
- 櫻花草視頻:無線信號放大器方案設計05-21
- 櫻花草視頻:多層阻抗PCB電路板加工02-09
- 櫻花草視頻:無線充電接收器PCBA方案11-19
- 櫻花草視頻:通訊電子PCBA加工案例三04-01
- 櫻花草視頻:工控產品主板PCB設計06-26
- 櫻花草視頻:激光噴碼機控制板設計開發方案09-21
相關技術
- 櫻花草視頻:什么是PCBA,PCB與PCBA的區別是什么?05-26
- 櫻花草視頻:PCBA常見英語術語解釋10-14
- 櫻花草視頻:高質量電子產品對加工條件的要求05-26
- 櫻花草視頻:PCBA生產加工操作通用規則05-27
- 櫻花草視頻:PCBA加工濕敏器件怎樣管理?05-27
- 櫻花草視頻:電子產品防水結構設計常見方式05-26
- 櫻花草視頻:電子產品PCBA加工清洗詳解05-27
- 櫻花草視頻:pcba加工機器主要有哪些,各有什么05-27
- 櫻花草視頻:PCBA加工印刷缺陷產生的原因及缺陷05-27
- 櫻花草視頻:什么是SMT鋼網,鋼網制作方法及鋼06-20

